【经验】解析漏极和源极之间产生的浪涌




漏极和源极间的浪涌是由各种电感分量和MOSFET寄生电容的谐振引起的。
在实际的版图设计中,很多情况下无法设计出可将线路电感降至最低的布局,此时,尽可能在开关器件的附近配备缓冲电路来降低线路电感,这是非常重要的。
首先,为您介绍SiC MOSFET功率转换电路中,发生在漏极和源极之间的浪涌。
SiC MOSFET的漏极和源极之间产生的浪涌
开关导通时,线路和电路板版图的电感之中会直接积蓄电能(电流能量)。当该能量与开关器件的寄生电容发生谐振时,就会在漏极和源极之间产生浪涌。下面将利用图1来说明发生浪涌时的振铃电流的路径。这是一个桥式结构,在High Side(以下简称HS)和Low Side(以下简称LS)之间连接了一个开关器件,该图是LS导通,电路中存在开关电流IMAIN的情形。通常,该IMAIN从VSW流入,通过线路电感LMAIN流动。
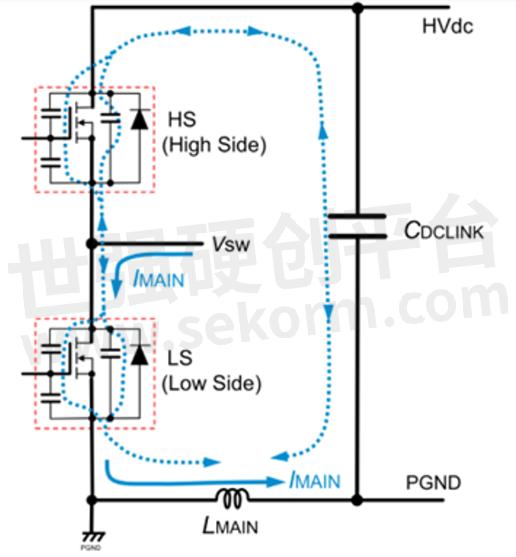
图 1 产生关断浪涌时的振铃电流路径
接下来,LS关断时,流向LMAIN的IMAIN一般是通过连在输入电源HVdc和PGND之间的大容量电容CDCLINK,经由HS和LS的寄生电容,按照虚线所示路径流动。此时,在LS的漏极和源极之间,LMAIN和SiC MOSFET的寄生电容COSS(CDS+CDG)就会产生谐振现象,漏极和源极之间就会产生浪涌。如果用VDS_SURGE表示施加在HVdc引脚的电压,用ROFF表示MOSFET关断时的电阻,则该浪涌的最大值VHVDC可以用下述公式表示。

公式 1
但是:

公式 2
图2是使用SiC MOSFETSCT2080KE进行测试时关断时的浪涌波形。当给HVdc施加800V的电压时,可以算出VDS_SURGE为961V,振铃频率约为33MHz。利用公式(1),根据该波形,可以算出LMAIN约为110nH。
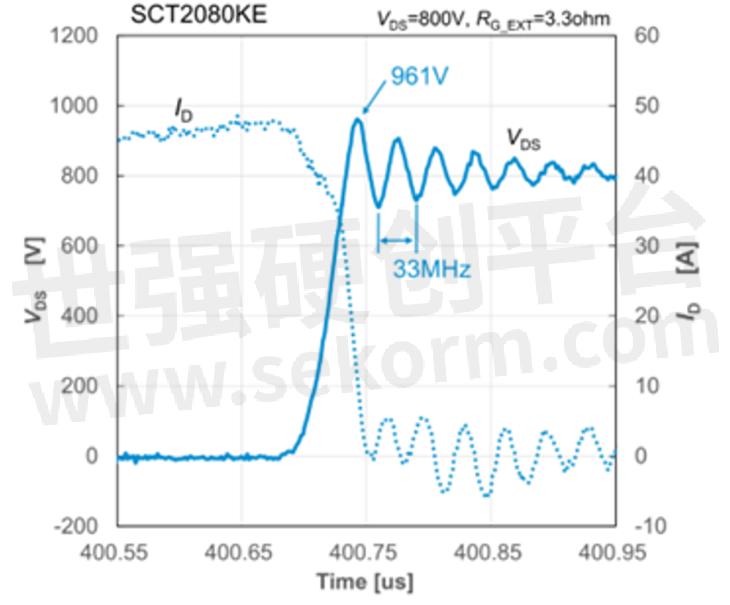
图 2 关断浪涌波形
再接下来,增加一个图3所示的缓冲电路CSNB,实质性地去掉LMAIN后,其关断浪涌的波形如图4所示。
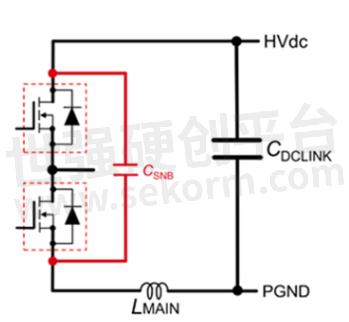
图 3 C缓冲电路
可以看到,增加该CSNB之后,浪涌电压降低50V以上(约901V),振铃频率也变得更高,达到44.6MHz,而且包括CSNB在内,整个电路中的LMAIN变得更小。

图 4 通过C缓冲电路降低关断浪涌
同样,利用公式(1)计算LMAIN,其结果由原来的110nH左右降低至71nH左右。原本,最好是在进行版图设计时,将线路电感控制在最低水平。但是,在实际设计过程中,往往会优先考虑器件的散热设计,所以线路并不一定能够按照理想进行设计。
在这种情况下,其对策方案之一就是尽可能在开关器件附近配置缓冲电路,使之形成旁路电路。这样既可以将线路电感这一引发浪涌的根源降至最低,还可以吸收已经降至最低的线路电感中积蓄的能量。然后,通过对开关器件的电压进行钳制,就可以降低关断浪涌。
- |
- +1 赞 0
- 收藏
- 评论 0
本文由三年不鸣转载自罗姆R课堂,原文标题为:漏极和源极之间产生的浪涌,本站所有转载文章系出于传递更多信息之目的,且明确注明来源,不希望被转载的媒体或个人可与我们联系,我们将立即进行删除处理。
相关推荐
【经验】简析Sic MOSFET相对于IGBT器件的三个优势:低导通损耗、低开关损耗、高驱动电压条件下更低导通电阻
ROHM的SCT2080KEHR是1200V,导通电阻是80mΩ,电流40A,封装TO-247-3的车规级SiC MOSFET,驱动电压范围VGSS在 -6V~+22V,驱动范围比较窄。本文以CT2080KEHR为例,对比市场通用的1200V/40A的TO-247-3的IGBT单管,说明Sic MOSFET在导通损耗和开关损耗上更具优势。
在EV应用中使用第4代SiC MOSFET的效果:图腾柱PFC实机评估
本文将介绍在相同的BEV电源架构的组成模块之一—OBC的双向图腾柱PFC中使用第4代SiC MOSFET时的实验结果。图腾柱PFC是作为可提高效率的PFC转换器在近年来备受关注的拓扑。另外,为了微电网系统更加稳定,并促进供需平衡,全球范围都在研究V2G(Vehicle To Grid),双向工作也变得越发重要。
【经验】以SIC MOSFET SCT3040KR为例说明SiC MOS应用中Vds关断尖峰的应对策略
在SiC MOS应用中,通常在mos关断过程中存在较大的Vds尖峰,主要原因在Turn ON 时流过的电流的能量储存在线路和基板布线的寄生电感中,并与开关元件的寄生电容共振所产生的。本文将以ROHM SiC MOSFET SCT3040KR为例说明SiC MOS应用中Vds关断尖峰的应对策略。
SiC MOSFET损耗计算方法:开关波形的测量方法
关于根据开关波形计算功率损耗的方法,本文中ROHM将为大家介绍SiC MOSFET开关波形的测量方法。近年来,一些示波器已经具备可以自动计算并显示所观测波形的功率损耗的功能,但如果没有该功能,就需要通过测得的波形来计算损耗了。为此,需要了解具体的测量方法和波形。
ROHM(罗姆) SiC(碳化硅)MOSFET选型指南(中文)
SiC MOSFET原理上在开关过程中不会产生拖尾尾电流,可高速运行且开关损耗低。低导通电阻和小型芯片尺寸造就较低的电容和栅极电荷。此外,SiC还具有如导通电阻增加量很小的优异的材料属性,并且有比导通电阻可能随着温度的升高而上升2倍以上的硅(Si)器件更优异的封装微型化和节能的优点。
ROHM - SIC场效应晶体管,SIC MOSFET,SCT3160KL,SCT4062KR,SCT3030KLHR,SCT4013DE,SCT3080AW7,SCT2450KE,SCT3160KW7,SCT2H12NZ,SCT4062KW7HR,SCT2450KEHR,SCT4013DR,SCT3060ALHR,SCT3040KRHR,SCT3060ARHR,SCT3040KLHR,SCT4036KEHR,SCT4045DRHR,SCT3022KLHR,SCT2160KE,SCT3080KW7,SCT3017ALHR,SCT3022AL,SCT3080ALHR,SCT3060AR,SCT3105KLHR,SCT4036KR,SCT3060AL,SCT4026DEHR,SCT4062KRHR,SCT3040KR,SCT2080KE,SCT3080KR,SCT3105KRHR,SCT3120AL,SCT4013DW7,SCT3030KL,SCT4062KWAHR,SCT4062KE,SCT3080ARHR,SCT4036KW7,SCT2280KEHR,SCT3120ALHR,SCT2280KE,SCT4062KWA,SCT3030AR,SCT3030AL,SCT3030AW7,SCT4036KRHR,SCT4045DEHR,SCT3120AW7,SCT3040KL,SCT3105KW7,SCT2080KEHR,SCT4018KW7,SCT4045DWA,SCT3080KL,SCT3030ALHR,SCT4062KW7,SCT3040KW7,SCT3022ALHR,SCT3030ARHR,SCT4045DW7,SCT3017AL,SCT4036KE,SCT4018KE,SCT4045DE,SCT4026DW7,SCT4062KEHR,SCT3080AR,SCT4026DW7HR,SCT4026DE,SCT4026DWA,SCT3160KLHR,SCT3080AL,SCT4045DW7HR,SCT4045DR,SCT2160KEHR,SCT3022KL,SCT4018KR,SCT4026DR,SCT4045DWAHR,SCT3105KL,SCT3160KW7HR,SCT3105KR,SCT3080KLHR,SCT3060AW7,SCT4026DRHR,SCT3080KRHR,SCT4026DWAHR
SiC MOSFET:通过波形的线性近似分割来计算损耗的方法
本文的关键要点:可以在线性近似有效范围内对所测得的波形进行分割,并使用示例公式进行损耗的近似计算;MOSFET开关工作时的总功率损耗是开关损耗和导通损耗之和。
SiC MOSFET损耗计算方法:通过波形的线性近似分割来计算损耗的方法
本文ROHM将介绍根据在上一篇文章(《SiC MOSFET损耗计算方法:开关波形的测量方法》)中测得的开关波形,使用线性近似法来计算功率损耗的方法。
【经验】如何通过增加栅极电容的方式减缓SiC MOSFET 的米勒效应
SiC MOSFET 同Si 基MOSFET和IGBT一样,由于存在米勒电容,都会有米勒效应的存在。由于SiC材料所带来的优势,SiC MOSFET可以工作在更高开关频率下,这样就会面临更严峻的误触发现象。所以在驱动电路设计中需要增加相关设计,使之能够较为有效地避免误触发。本文将主要介绍增加栅极电容的方式。
ROHM SiC MOSFETs Contribute to Smaller, More Efficient, Reliable High Power Bidirectional Power Supplies
ROHM SiC MOSFETs Contribute to Smaller, More Efficient, Reliable High Power Bidirectional Power Supplies.ROHM‘s products were essential to the development of a high reliability, high efficiency 3U20kW bidirectional large-capacity DC power supply.
在EV应用中使用第4代SiC MOSFET的效果:装入牵引逆变器实施模拟行驶试验
本文将介绍牵引逆变器的基本工作和在EV中的评估系统(电机试验台的测试环境)。然后使用其测试结果,按照乘用车油耗测试方法WTLC实施模拟行驶仿真,并通过示例来了解使用第4代SiC MOSFET改善电耗的效果。
【产品】采用TO263-7L封装的AC/DC转换器IC适用于通用逆变器, 内置1700V耐压的SiC MOSFET
ROHM推出的BM2SC12xFP2-LBZ是业内先进的AC/DC转换器IC,采用一体化封装, 内置1700V耐压SiC MOSFET,使采用了SiC MOSFET的高效AC/DC转换器的设计更容易。
SiC MOSFET缓冲电路设计方法
与传统的功率半导体相比,SiC MOSFET的开关速度更快,因此其电压和电流变化更急剧。这使得器件自身的封装电感和外围电路的布线电感等的影响变大(已经不容忽视),最终会导致较大的浪涌。关于这种浪涌的抑制方法,我们已经介绍过其中一种,即缓冲电路的增加方法和设计方法。
【经验】以SCT3040KL/R为例说明To-247-4L封装SiC MOSFET相对于3L封装产品性能更优
TO-247系列的SiC MOSFET的4L封装是在3L封装上对源极进行优化的产品。ROHM的SCT3040KL和SCT3040KR分别是3L和4L的SiC MOSFET。本文以这两个产品为例,从应用电路图和开关测试波形图进行分析,比较4L封装的产品在性能上更优于3L产品。
ROHM采用SiC MOSFET开发Trans-link交错型逆变器,实现5kW时功率转换效率99%以上
罗姆(ROHM)采用了发挥碳化硅(SiC)MOSFET高频特性的Trans-link交错型逆变电路、实现了5kW时的功率转换效率达到99%以上。在该电路拓扑中,平滑电抗器的电感量可以减小。
在EV应用中使用第4代SiC MOSFET的效果
EV(电动汽车)有多种类型。在BEV(纯电动汽车)、HEV(混合动力汽车)、PHEV(插电式混合动力汽车)和Series HEV(串联式混合动力汽车)等不同的产品类型中,电源架构会因具体用途而有所不同。其中,最近备受关注的是BEV的双向/快速充电应用中的电池电压为400V或800V的电源架构。
电子商城
现货市场
服务
定制液冷板尺寸5mm*5mm~3m*1.8m,厚度2mm-100mm,单相液冷板散热能力最高300W/cm²。
最小起订量: 1片 提交需求>






































































































































































































登录 | 立即注册
提交评论