【产品】导热系数1.9W/m·K的德聚双组分导热环氧树脂EW 6620-20,适用于低CTE导热灌装




德聚双组分导热环氧树脂EW 6620-20是一种双组分环氧树脂粘合剂。具有良好的导热性,可用于各种基板上的元件键合和封装,尤其是低CTE导热灌装。
主要特征:
•推荐基材:不锈钢、铝、铜
•在机械应力和热冲击下具有优异的可靠性
•低CTE高Tg
•高导热系数
固化前特性
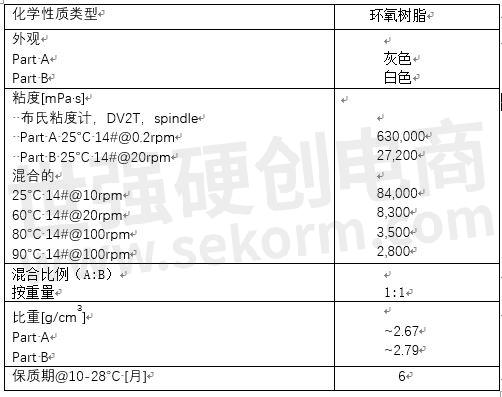
固化条件

固化后特性

使用说明
1、表面处理
要粘合的表面应无灰尘、油、油脂或任何其他污染物,以实现可重复的粘合。对于轻微污染的表面,用异丙醇或乙醇擦拭即可。具有低表面能的基材(如聚乙烯、聚丙烯、特氟龙)需要进行物理预处理(例如采用大气等离子体处理或电晕表面处理技术),以获得足够的附着力。
2、应用条件
产品已准备好供使用,根据包装类型不同,可用于手动、半自动或全自动使用剂量设备输送装置。对于来自盒装中无触点自动点胶,粘合剂通过压力和活塞杆输送到阀门中,对于瓶装中的粘合剂,可通过泵技术设备完成点胶操作。应用后,建议立即将两个基材连接在一起,因为在适当工作环境条件下,可能产品会开始固化处理。
3、建议工作温度范围为-40~160℃。
贮存:储存产品在最佳温度为10℃~28℃范围内的阴凉干燥处可获得最长的保质期。为防止未使用产品受到污染,请勿将任何未用完产品倒回其原始容器中。
物料处理:请参考此产品的MSDS
- |
- +1 赞 0
- 收藏
- 评论 0
本文由砌墙的小熊翻译自德聚,版权归世强硬创平台所有,非经授权,任何媒体、网站或个人不得转载,授权转载时须注明“来源:世强硬创平台”。
相关推荐
【产品】低CTE高Tg的双组分环氧树脂粘合剂EW 6620-10,可用于各种基板上的元件键合和封装
德聚推出的EW 6620-10是一种双组分环氧树脂粘合剂,具有良好的导热性,可用于各种基板上的元件键合和封装,尤其是低CTE导热灌装。
【产品】德聚推出单组分醇酸粘合剂N-Coat 9560,粘度低且流动性好,用于组装电路板的保护和绝缘
N-Coat 9560是德聚推出的一种单组分醇酸粘合剂,用于组装电路板的保护和绝缘。对FPC和PCB有极好的附着力,粘度低,流动性好,具有极好的柔韧性,优异的电气性能和抗环境性能,可通过自动/手动过程、浸渍、喷涂或刷洗,易于涂抹。
德聚半导体固晶胶解决方案提供稳定可靠的封装连接,为半导体封装工艺提供更多优化选择
在半导体封装领域,固晶胶和DAF膜是常见的粘接材料,用于牢固固定芯片和基板。相较于上一期介绍的DAF膜解决方案,德聚的半导体固晶胶产品提供了多样化的选择,以满足客户不同工艺需求。本期将深入介绍德聚半导体固晶胶解决方案,为半导体封装工艺提供更多优化选择。
EW 6662G双组分环氧树脂实验室数据表
描述- EW 6662G是一种双组分环氧树脂粘合剂,适用于灌封、层压和电气/电子绝缘。它具有良好的粘附性、优异的机械应力、热冲击和温度湿度偏差下的可靠性,以及低收缩率。
型号- EW 6662G
EW 6652 A/B双组分环氧粘合剂
描述- EW 6652 A/B 是一种双组分环氧树脂胶粘剂,适用于电子元件的粘接或灌封。该产品具有优异的附着力、低粘度、良好的防水和耐老化性能。
型号- EW 6652 B,EW 6652 A
NEVS粘合剂解决方案
型号- EW 6325H,N-SIL 8063G,N-SIL 8135,N-SIL 8630,N-PU 5103M,N-SIL 8742,N-SIL 8556,N-PU 5801,N-SIL 8625,N-SIL 8901,N-SIL 8518,AW 2925,N-SIL 8558H,N-PU 5820,AW 2902,N-PU 5601,EW 6300M4,N-PU 5801N
EW 6620-20双组分导热环氧树脂
描述- EW 6620-20是一种双组分热导环氧胶粘剂,适用于各种基材上的元件粘接和灌封。该产品具有良好的热传导性、低热膨胀系数和高玻璃化转变温度,适合低温热导电灌封。
型号- EW 6620-20
EW 6620-10双组分导热环氧树脂
描述- EW 6620-10是一种双组分热导环氧树脂胶粘剂,适用于各种基材上的元件粘接和灌封。该产品具有良好的热传导性、低热膨胀系数和高玻璃化转变温度,适合低温热导灌封。
型号- EW 6620-10
T-BOND E90双组分环氧树脂,高导热性,阻燃性(UL94,V-0)技术数据表
描述- T-Bond E90是一种双组分环氧树脂胶粘剂,具有中等粘度、适中的固化速度和高强度粘接性能。该产品具备高热导率、符合UL 94 V-0阻燃标准且不含溶剂的特点,适用于多种金属、塑料和陶瓷基板材料的粘接。
型号- T-BOND E90
EW 6615双组分环氧树脂技术数据表
描述- EW 6615是一种双组分环氧树脂胶粘剂,具有低收缩率和高填充量。适用于组件灌封和粘合。该产品具有良好的耐湿性、抗老化、热冲击和机械应力性能。
型号- EW 6615
EW 6680双组分环氧树脂技术数据表
描述- EW 6680是一种快速固化环氧树脂胶粘剂,适用于组件灌封和结构粘接。该产品具有透明度高、固化速度快和环境耐久性好等特点,主要用于充电器等电子设备的组件灌封。
型号- EW 6680
T-BOND E8双组分环氧树脂,高导热性,阻燃性(UL94,V-0)技术数据表
描述- T-Bond E8是一种双组分环氧树脂胶粘剂,具有高导热系数、阻燃性(符合UL 94 V-0标准)和环境友好性。该产品具有快速固化速度和高粘接强度,适用于多种金属、塑料和陶瓷基板。
型号- T-BOND E8
电子商城
服务
可定制丙烯酸酯胶粘剂的粘度范围:250~36000 mPa·s,硬度范围:50Shore 00~85Shore D,其他参数如外观颜色,固化能量等也可按需定制。
最小起订量: 1 提交需求>
提供多种可压缩材料如导热硅胶、散热垫片、各种相变材料以及其他粘合剂和固体试样的材料导热系数测试,给出测试结果及数据解析报告;测试范围:最大加热电流5A;热阻范围:0.01K/W-5K/W。
实验室地址: 深圳 提交需求>






























































































































































































登录 | 立即注册
提交评论